2024知到答案 半导体器件物理(中山大学) 完整智慧树网课章节测试答案
第一章 单元测试
1、判断题:
对于离子注入或在轻掺杂的原始晶片上进行浅结扩散的情况,突变结是一个可接受的近似。( )
选项:
A:错
B:对
答案: 【对】
2、判断题:
理想PN结的内建电势小于禁带宽度的电压值。( )
选项:
A:对
B:错
答案: 【对】
3、单选题:
线性缓变结的耗尽层宽度正比于( )
选项:
A:
B: 其中,
其中, 为轻掺杂一侧的杂质浓度
为轻掺杂一侧的杂质浓度
C:
D:
答案: 【 】
】
4、单选题:
下面哪个图代表线性缓变PN结热平衡的电场分布:( )
选项:
A:
B: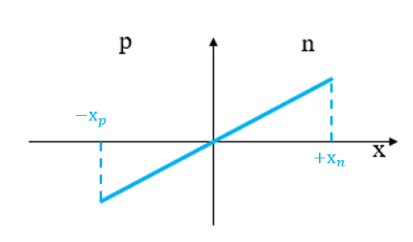
C:
D:
答案: 【 】
】
5、判断题:
PN结的p型和n型间的势垒随正向偏压的增加而升高。( )
选项:
A:错
B:对
答案: 【错】
6、单选题:
在反向偏置下,靠近PN结耗尽区边界的准中性区内载流子会发生什么过程?( )
选项:
A:扩散和复合
B:产生和扩散
C:产生和漂移
D:漂移和扩散
答案: 【产生和扩散】
7、单选题:
下面那个图正确表示了PN结正偏的少子浓度分布图:( )
选项:
A: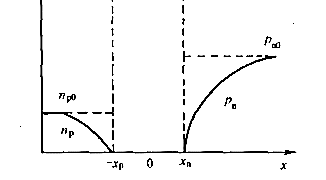
B:
C:
答案: 【 】
】
8、单选题:
在推导理想二极管方程中,下面哪一个假定没有使用?( )
选项:
A:不存在“其他”过程,也就是说没有光子产生,也没有雪崩和隧穿发生,等等。
B:在耗尽区中没有复合-产生
C:窄基区二极管,即n和p的准中性宽度远小于各自的少数载流子扩散长度。
D:小注入水平
答案: 【窄基区二极管,即n和p的准中性宽度远小于各自的少数载流子扩散长度。】
9、判断题:
在理想pn结中,正偏稳态扩散时,单位时间、单位体积内扩散和漂移积累的少子数量等于复合损失的少子的数量。( )
选项:
A:错
B:对
答案: 【错】
10、判断题:
正偏稳态理想pn结中,载流子的连续性方程为 。(
。( >0,
>0, >0)( )
>0)( )
选项:
A:对
B:错
答案: 【错】
11、判断题:
PN结正偏时,扩散区中非平衡少子浓度随扩散距离的增大而指数增大,逐渐趋向热平衡值。( )
选项:
A:对
B:错
答案: 【错】
12、单选题:
以下哪个选项是理想二极管电压-电流公式中的与外加偏压无关的参数J0:( )
选项:
A:
B:
C:
D:
答案: 【 】
】
13、判断题:
反偏PN结空间电荷区 。( )
。( )
选项:
A:对
B:错
答案: 【错】
14、单选题:
以下哪个不属于PN结伏安特性非理想效应( )
选项:
A:耗尽区扩散电流(正偏)
B:耗尽区产生电流(反偏)
C:载流子大注入(正偏)
D:结击穿(反偏)
答案: 【耗尽区扩散电流(正偏)】
15、单选题:
下面哪一种说法是不正确的?( )
选项:
A:雪崩击穿电压近似地随p+-n和n+-p结中轻掺杂一侧的掺杂浓度成反比变化。
B:在保持于室温下的硅二极管中,如果 ,那么齐纳是造成击穿的主要原因。
,那么齐纳是造成击穿的主要原因。
C:PN结雪崩和齐纳击穿都是可恢复的过程
D:如果要在PN结二极管中发生齐纳过程,要求耗尽区宽度必须非常窄(<10-6 cm)
答案: 【在保持于室温下的硅二极管中,如果 ,那么齐纳是造成击穿的主要原因。】
,那么齐纳是造成击穿的主要原因。】
16、判断题:
PN结在较低正偏压下,随正向电压的增加,扩散电流变的越来越不占主导。( )
选项:
A:对
B:错
答案: 【错】
17、判断题:
相同正偏压下,相同掺杂浓度分布的硅PN结比锗PN结空间电荷区复合电( )流大。
选项:
A:错
B:对
答案: 【对】
18、单选题:
下图表示了PN结正偏电流随正向偏压的变化曲线,c区域中:( )
选项:
A:
B:
C:
D:
答案: 【 】
】
19、判断题:
PN结的势垒电容随反偏电压的增大而增大。( )
选项:
A:错
B:对
答案: 【错】
20、单选题:
下面关于PN结的势垒电容和扩散电容的说法哪个是正确的?( )
选项:
A:这两个电容都是因为势垒区中的电荷随外偏压变化而引起的
B:减少PN结结面积可以减少这两个电容
C:势垒电容只存在于反偏压下,扩散电容只存在于正偏压下
D:这两个电容的正负电荷在空间上都是重叠的;
答案: 【减少PN结结面积可以减少这两个电容】
21、单选题:
关于PN结的扩散电容的描述,以下哪一个是不正确的( )
选项:
A:减少少子寿命可以减小扩散电容
B:正向偏压越大,扩散电容越大
C:扩散电容在高频电路中特别重要,而在低频时扩散电容很小。
D:工作电流越大,扩散电容越大
答案: 【扩散电容在高频电路中特别重要,而在低频时扩散电容很小。】
22、判断题:
PN结小信号模型中的准静态是指信号变化速率低于器件内载流子弛豫到稳态的速率,即器件内部的载流子分布的变化跟得上信号的变化。( )
选项:
A:错
B:对
答案: 【对】
23、判断题:
PN结由正偏突变成反偏时,电流与电压存在延迟现象,这是因为正偏稳态存储的电荷不能立刻消失。( )
选项:
A:错
B:对
答案: 【对】
24、判断题:
PN结由正偏突变成反偏时,立刻出现少子抽取。( )
选项:
A:对
B:错
答案: 【错】
25、单选题:
下图给出了硅PN结关断过程的电流随时间的变化曲线,判断下面说法正确的是:( )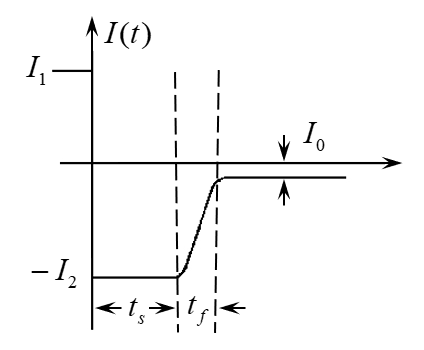
选项:
A:若I1提高两倍,则 相应的增大两倍
相应的增大两倍
B: 为存储时间,即空间电荷区边缘少子浓度达到热平衡值所经历的时间
为存储时间,即空间电荷区边缘少子浓度达到热平衡值所经历的时间
C:总的关断时间为
D:减小I2或掺金有助于提高关断速度
答案: 【 为存储时间,即空间电荷区边缘少子浓度达到热平衡值所经历的时间】
为存储时间,即空间电荷区边缘少子浓度达到热平衡值所经历的时间】
第二章 单元测试
1、判断题:
晶体管是一种无源器件。( )
选项:
A:对
B:错
答案: 【错】
2、判断题:
双极型晶体管是通过调控结势垒高度来控制电流大小,场效应晶体管是通过调节导电沟道的电导来控制电流。( )
选项:
A:对
B:错
答案: 【对】
3、单选题:
关于理想MOS结构的描述,下面不正确的是( )
选项:
A:金属与半导体之间存在一个电势差
B:氧化层不导电,也不荷电
C:半导体足够厚,不管加什么栅电压,在达到背接触之前总有一个零电场区域(即所谓硅体区)
D:金属栅足够厚,在交流和直流偏置条件下可以看作为一个等电势区
答案: 【金属与半导体之间存在一个电势差】
4、单选题:
理想n型MOS电容的不同静态偏置下的能带图如下所示,其中对应载流子反型程度最强的是(), 表示所施加的栅极的电压( )
表示所施加的栅极的电压( )
选项:
A:
B: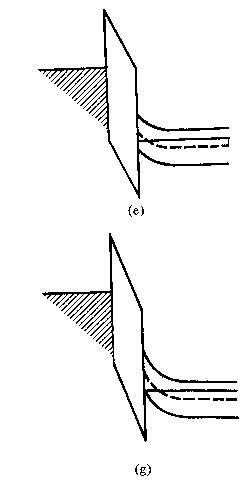
C: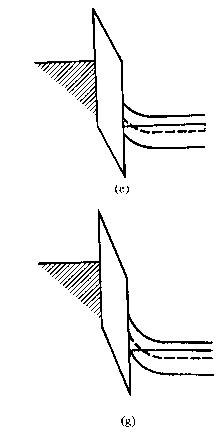
D: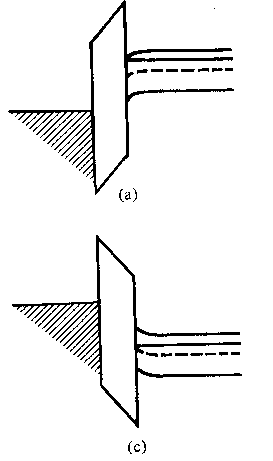
答案: 【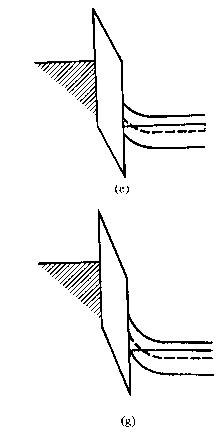 】
】
5、单选题:
下面关于MOS电容表面势 与费米势
与费米势 的说法错误的是:( )
的说法错误的是:( )
选项:
A:费米势 的符号可以反映掺杂类型,如果半导体为P型,则
的符号可以反映掺杂类型,如果半导体为P型,则 ;如果为n型,则
;如果为n型,则
B: 的大小与掺杂浓度有关
的大小与掺杂浓度有关
C: 是半导体发生反型的临界条件
是半导体发生反型的临界条件
D:表面势 是体内
是体内 与表面
与表面 之间的势垒高度
之间的势垒高度
答案: 【费米势 的符号可以反映掺杂类型,如果半导体为P型,则
的符号可以反映掺杂类型,如果半导体为P型,则 ;如果为n型,则
;如果为n型,则 】
】
6、判断题:
半导体的电子亲和势 是真空能级与半导体表面的导带能级Ec之差。( )
是真空能级与半导体表面的导带能级Ec之差。( )
选项:
A:对
B:错
答案: 【对】
7、判断题:
在测量MOS电容低频C-V特性时采用“准静态技术”。( )
选项:
A:错
B:对
答案: 【对】
8、单选题:
下图是p型衬底的MOS电容随栅压的变化关系图,下列说法不正确的是:( )
选项:
A:CD段处于耗尽区
B:EF段发生在高频强反型区
C:AB段总电容由绝缘层电容决定(类同于平行电容器)
D:当信号频率比较高,耗尽层中电子—空穴对的产生和复合跟不上信号的变化,反型层中的电子电荷Qn来不及改变,在高频情况下C维持极小值,如DG段所示
答案: 【EF段发生在高频强反型区】
9、单选题:
下图中表示氧化层正的陷阱电荷引起的N型MOS电容C-V曲线平移的是( )
选项:
A: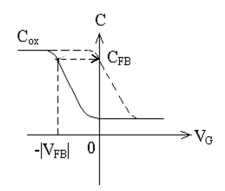
B: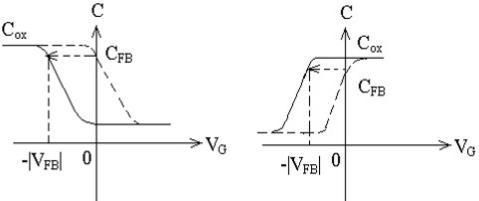
C: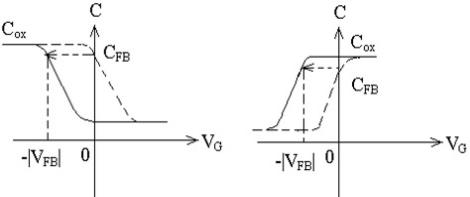
D: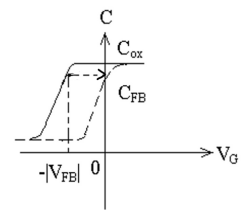
答案: 【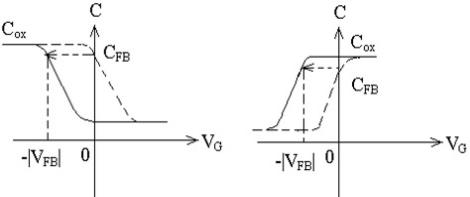 】
】
10、判断题:
“场效应”是指载流子被平行于半导体表面的电场加速的现象。( )
选项:
A:对
B:错
答案: 【错】
11、单选题:
下列对MOSFET阈值电压衬底偏置效应(反向偏置)描述正确的是:( )
选项:
A:衬偏效应会导致阈值电压减小
B:衬偏效应会导致阈值电压增大
C:对于pMOS,为了保证不发生衬偏效应,需要保证源到衬底PN结必须为零或反偏
D:对于nMOS,为了保证不发生衬偏效应,需要保证源到衬底的PN结必须为零或反偏
答案: 【对于nMOS,为了保证不发生衬偏效应,需要保证源到衬底的PN结必须为零或反偏】
12、单选题:
下面关于影响MOSFET阈值电压大小的因素不包括:( )
选项:
A:所施加的栅电压大小
B:界面固定电荷
C:氧化层厚度
D:功函数差
答案: 【所施加的栅电压大小】
13、判断题:
理想MOSFET采用的缓变沟道近似是指沿垂直于沟道方向电场变化很小。( )
选项:
A:错
B:对
答案: 【错】
14、判断题:
MOSFET的亚阈值电流正比于表面势的指数.( )
选项:
A:对
B:错
答案: 【对】
15、单选题:
下列减小MOSFET亚阈值摆幅的途径不包括( )
选项:
A:减小界面充放电电荷密度Nss
B:减小势垒电容Cd
C:器件工作温度不能过高
D:减小氧化层电容COX
答案: 【减小氧化层电容COX】
16、单选题:
MOSFET中会有哪些寄生电容( )
选项:
A:都是
B:源极、漏极和衬底之间的寄生PN结电容,分别写成CGS和CGD
C:栅极和源之间的交叠部分有交叠MOS电容,分别写成CGSO和CGDO
D:栅极和源之间不交叠的部分则存在分布电容,分别写成CGS和CGD
E:栅极沟道和衬底之间也存在栅衬电容,表示为CGB
答案: 【都是】
17、单选题:
下列对于MOSFET的栅源、栅漏之间的分布电容描述不正确的是:( )
选项:
A:栅源分布电容CGS等于栅氧化层存储电荷QG随栅源电压VGS的变化率,栅漏分布电容CGD的定义同理
B:当器件进入饱和区,栅源之间的分布电容CGS等于总氧化层电容CG的二分之三
C:考虑到线性区中漏极电压很小,栅源电压与栅漏电压近似相等,栅源、栅漏分布电容均等于
D:当器件进入饱和区,漏端附近的沟道夹断,反型层消失,栅极电荷将不随漏极电压变化而变化,此时栅漏之间的分布电容CGD为零
答案: 【当器件进入饱和区,栅源之间的分布电容CGS等于总氧化层电容CG的二分之三】
18、单选题:
实际MOSFET高频等效电路相比理想MOSFET高频等效电容多考虑了哪些因素?( )
选项:
A:都是
B:栅源和栅漏交叠电容CGSO和CGDO
C:在实际电路连接中,源极和漏极与外部端口之间存在一定的体电阻Rs和Rd
D:源极与衬底、漏极与衬底之间存在寄生PN结DS和DD以及相应的结电容Cjs和Cjd
答案: 【都是】
19、判断题:
MOSFET器件截止频率fT,定义为跨导衰减到低频跨导gm的的 时(也就是功率跨导减小到低频时的2分之1时)。( )
时(也就是功率跨导减小到低频时的2分之1时)。( )
选项:
A:对
B:错
答案: 【错】
20、判断题:
MOSFET器件的跨导截止频率和器件截止频率均越高越好。( )
选项:
A:错
B:对
答案: 【对】
21、单选题:
提升MOSFET截止频率的方法错误的是( )
选项:
A:选用高迁移率材料,例如NMOS、应变硅、高迁移率化合物半导体
B:让器件工作在饱和区,让栅漏之间断路,避免栅漏分布电容的影响
C:减小半导体表面态和界面态,削弱载流子在表面或界面上的散射
D:增大沟道长度,减少短沟道效应
答案: 【增大沟道长度,减少短沟道效应】
